
该工作介绍一种新型的短沟道二维场效应晶体管(FET),通过构建斜坡架构实现纳米级沟道长度,无需光刻技术。利用六方氮化硼(h-BN)隧穿层,有效缓解短沟道效应(SCE),实现了高开关比和低亚阈值摆幅(SS)。该斜坡架构短沟道FET(SSFET)展现出超过10⁵的开关比、160 mV/dec的亚阈值摆幅和3.70 μA的导通电流。这种新方法为实现纳米级FET提供了创新路径,无需复杂制造工艺,为未来应用提供高开关比、高开关速度和增强的载流子迁移率。该成果以题为“Short Channel 2D FET with Sloped Architecture”发表于ACS Applied Materials & Interfaces期刊。
技术亮点:
² 新型斜坡架构:通过构建斜坡架构实现了纳米级沟道长度,无需光刻技术,为实现纳米级FET提供了创新路径;
² h-BN隧穿层的应用:利用h-BN隧穿层有效缓解短沟道效应,实现高开关比和低亚阈值摆幅,同时保持了低隧穿电阻;
² 高性能表现:SSFET展现出超过10⁵的开关比、160 mV/dec的亚阈值摆幅和3.70 μA的导通电流,性能优于传统FET;
² 温度依赖特性:通过温度依赖的电荷传输测量,揭示泄漏电流主要源自热发射电流,通过插入h-BN隧穿层显著抑制这种泄漏电流;
² 材料通用性:该架构对通道材料的选择没有限制,只要所选材料具有原子级厚度和机械灵活性,即可使用。通过使用CVD生长的WSe₂晶体作为通道材料,验证了p型传输特性。
图文分析:

图1. (a)通过顺序堆叠金电极、单层MoS2和h-BN隧穿层制备的斜沟道超短沟道FET示意图。(b)斜沟道短沟道FET的原子力显微镜形貌图及单层MoS2的线轮廓图(插图)。(c)截面透射电镜图像证实存在亚10纳米斜沟道区域及空气间隙。(d)斜沟道短沟道FET的EDS元素分布图:钼(红色)、硫(黄色)、金(绿色)、铟(蓝色)。
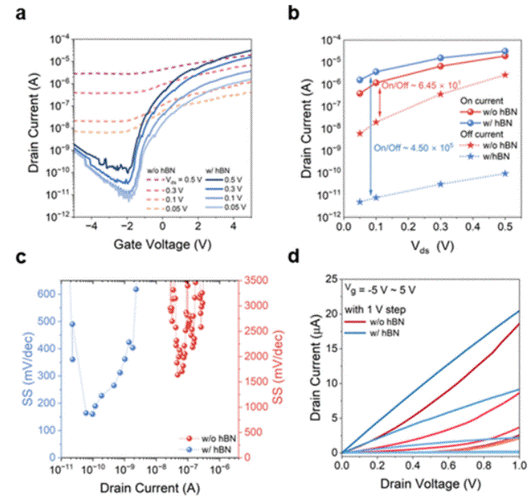
图2. (a)含h-BN隧穿层(蓝线)与不含h-BN层(红点线)的斜沟道短沟道FET转移特性曲线。(b)从(a)转移曲线提取的导通电流(Vg=5V时)与关断电流随Vds的变化关系。(c)转移特性曲线提取的亚阈值摆幅(SS)值。(d)含与不含h-BN层的斜沟道短沟道FET输出特性曲线。。
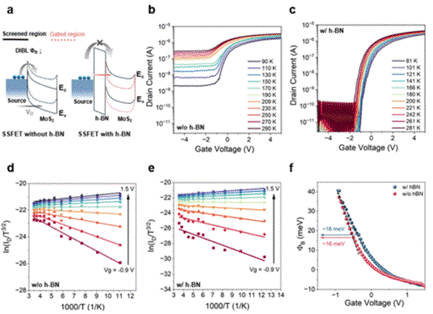
图3. (a)金电极(黑线,屏蔽区)和斜沟道区(红线,栅控区)构成的夹层区域能带图及电荷传输机制,右图为含h-BN隧穿层结构,左图为无h-BN层结构。(b)、(c)分别为含与不含h-BN层的斜沟道短沟道FET的温度依赖性电荷传输特性。(d)、(e)斜沟道短沟道FET的阿伦尼乌斯曲线。(f)提取的肖特基势垒高度随栅压Vg的变化关系。
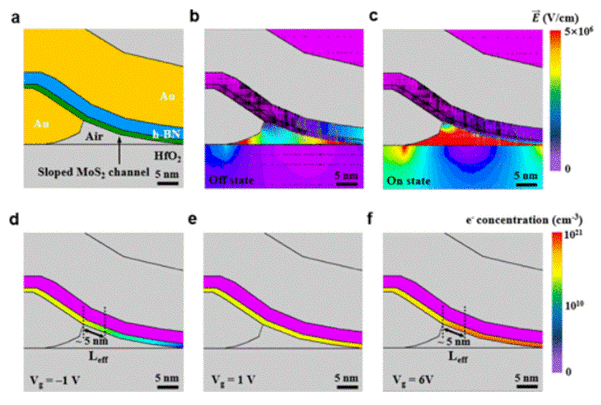
图4. (a) SSFET中电场分布和载流子浓度变化的模拟结构示意图。(b)、(c) 在关态(Vg = −1 V)和开态(Vg = 6 V)下,SSFET结构中的电场分布模拟结果。(d)、(e)、(f) 分别在Vg = −1 V、1 V和6 V时,斜坡沟道区域电子浓度的变化情况。
结论展望
本文通过构建斜坡架构实现了纳米级沟道长度的短沟道FET,无需光刻技术。通过插入h-BN隧穿层,有效缓解了短沟道效应,实现了高开关比和低亚阈值摆幅。该架构不仅适用于n型MoS₂,还适用于p型WSe₂,展现出良好的通用性。这种新型SSFET架构为实现纳米级FET提供了创新路径,无需复杂制造工艺,为未来应用提供了高开关比、高开关速度和增强的载流子迁移率。
文献来源
Junsung Byeon, Jinhyeok Pyo, Jungmoon Lim, et al.Charge transport in mixed metal halide perovskite semiconductors. ACS Applied Materials & Interfaces (2025).
https://doi.org/10.1021/acsami.5c18886
仅用于学术分享,如有侵权,请联系删除。
索比光伏网 https://news.solarbe.com/202510/28/50011193.html



