索比光伏网讯:备注:在本篇讨论多晶硅还原反应的影响因素的文章中,有一部分是引用已公开在网上的资料。由于这些资料基本上没有标明作者和出处,因此本文中也未做说明。如有作者发现是引用其著作,因及时反馈以便在文中进行标注。
多晶硅在还原炉内的沉积过程受到众多因素的影响,包括还原炉结构、硅棒布置方式、沉积温度、炉内压力、三氯氢硅和氢气的流量以及二者的配比、停留时间以及硅棒的电流、电压等。这些因素相互制约,相互影响,对多晶硅的沉积质量以及单位产品电耗都有直接的关系。
1、反应温度
SiHCl3被氢气还原以及热分解的反应是吸热反应。所以,从理论上来说,反应的温度愈高则愈有利于反应的进行,此时硅的沉积速率也就越高。温度愈高,沉积速度愈快,达到反应平衡的时间也越短,趋向平衡的程度也越近。
系统含SiHCl3、SiCl4、H2、HCl、SiH2Cl2以及硅粉的组份,在800℃~1400℃之间的吉布斯自由能最小原则进行计算平衡时各组份的平衡量,氢气和TCS的量分别为3kmol/hr和1Kmol/hr。
从图1就可以看出,随着温度升高,达到平衡状态时,系统的硅收率增加,STC降低,H2的耗量明显增加(系统中H2的含量随着温度的升高而降低)。在图1中,当温度升到1150℃之后,TCS的变化趋势和1150℃之前相差不大,但STC的变化却加快。1150℃之后HCl斜率几乎是之前的两倍。
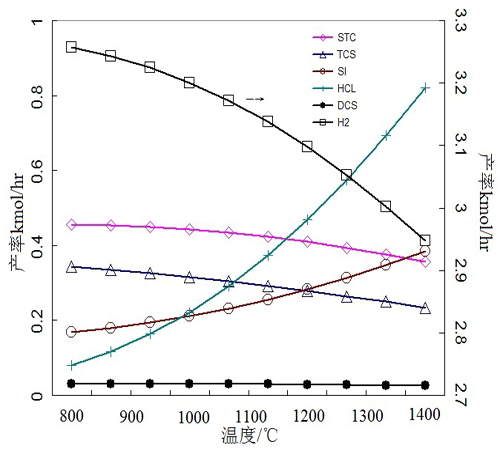
图1 温度对各组分含量的影响
结合下面两反应式(1)和(2),
SiHCl3+H2-→Si + 3HCl - Q ………………………(1)
SiHCl3+3HCl-→SiCl4+ 2H2 + Q ………………………(2)
可以看出,随着反应温度增加,Si和HCl的生成量在增加,氢气的耗量在增加,而SiCl4的生成量在减少。说明温度升高,对(1)有利,对(2)有抑制作用。另外反应(2)从右向左即是SiCl4的热氢化工艺,即反应温度升高,不仅可以增加硅的收率,而且可以抑制三氯氢硅变成四氯化硅。
温度升高,对硅的转化率有利,这是因为硅棒的生长主要是化学气相沉积。但另一方面,硅在硅棒表面沉积,又是一个物理过程。根据Langmuir吸附公式,温度升高会导致解析速率增加,吸附速率降低。所以在实际生产过程中,温度并非越高越好。实际沉积过程中,半导体材料自气相向固态载体上沉积时都有最高温度Tmax,当反应温度超过这个温度时,随着温度的升高沉积速率反而下降,各种不同的硅卤化物有不同的Tmax。此外,还有一个平衡温度T0,高于该温度才开始反应析出硅。一般在反应平衡温度和最大温度之间,沉积速率随着温度升高而增大,如图2所示。
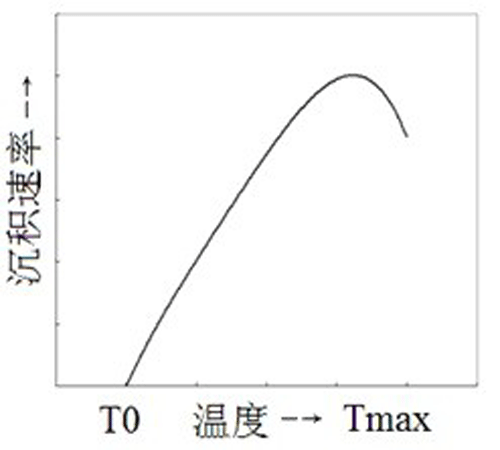
图2 温度与沉积速率的关系
三氯氢硅在900~1050℃范围内以热分解为主,在1050~1200℃之间以氢还原为主。但这只是一个大致的趋势,其实在900~1050℃范围内也会有氢还原反应发生。三氯氢硅反应温度较四氯化硅的略低,因此可以相应减少还原炉设备杂质挥发所引起的污染。
另外沉积过程中,组份的输运还受Soret热效应的影响。Soret热效应通常指凝聚相的热扩散现象,即在不均匀的温度场中,混合物的组份向不等温的冷热两壁发生迁移浓缩,形成浓度梯度,分子量大的向冷区聚积,分子量小的向热区聚积,故在硅棒表面邻近区域,HCl比TCS更容易贴近硅棒表面,使得反应速率受到限制如图3和图4所示


图3、Soret热效应对SiHCl3分布的影响 图4、Soret热效应对生长速率的影响
其中图3 中:a、环形空隙温度分布;b、无Soret热效应影响的TCS分布;c、Soret热效应影响下的TCS分布。
温度升高,无论从化学反应平衡还是从反应动力学方面,都能够使反应向有利的方向进行,加快反应速度。但同时由于:①存在Soret效应,②HCl和SiCl4在高温下对硅棒具有刻蚀作用,③高温导致反应气体不能到达硅棒表面,即化学气相沉积未在硅棒表面发生,而是在高温区的气相中就已经反应了,使得硅粉微粒被气相带出反应器,所以硅棒表面的温度不能过高。
增加反应温度还对结晶性能也有益。温度高,结晶粗大,而且表面具有很亮的金属光泽;但是温度过高,如超过1200℃,则会发生逆腐蚀反应,使硅容易熔化;反之,温度底,结晶细小,表面呈暗灰色,当温度低于900℃时,则会生成疏松的暗褐色无定形硅,如有时候在还原炉石墨电极上,会覆盖一层无定形硅。
硅的腐蚀反应:

由于硅的沉积速率受温度的影响最大,所以温度对硅棒表面形态的影响程度也很大。
多晶硅形态等级(morphology level rating)一般可以分为7级,1级为硅棒光滑致密,7级为最粗糙,呈爆米花(popcorn)状。形态等级差的硅棒致使在化学清洗时不易处理干净,杂质和水份残留在多晶硅表面,影响区熔成晶,甚至迫使中断拉晶操作。即使用作直拉料,也会由于杂质玷污,使单晶纯度下降。
硅棒表面形态均匀性的根本原因是硅的沉积速度和硅棒表面所能吸收并使之形成晶体的速度之间的差异。当化学反应沉积速度大于硅棒表面成晶速度时,晶粒来不及在硅棒表面进行有序的排列,就会造成硅棒表面的不均匀。有许多因素可以影响硅的沉积速度从而造成硅棒的畸形生长,影响多晶硅形态等级,例如硅棒表面温度及温度不均匀性,进料气体的流量和组份的摩尔配比,原料混合气的纯度,甚至硅芯的安装垂直度等。
图5为各种硅棒表面的形态。

a、不同位置处的硅棒表面形态 b、光滑的硅棒表面 c、粗糙的硅棒表面
图5、各种硅棒表面形态
硅棒生长过程中,具有“自调节效应”,使得硅棒在生长过程中,不会导致粗的地方越粗,细的地方越细的现象,而是通过自调节,使得产品硅棒上下各处粗细趋向均匀。
当硅棒表面的温度超过某一个最大值(Tmax)时,气相向硅棒表面沉积的速度随着温度的升高反而下降,随着温度的下降反而上升。在此温度区(>Tmax),由于受到对流的影响,硅棒表面的温度分布会发生波动而不均匀。温度低的地方,沉积速度快而产生凸起,凸起的表面易散热而会使温度变低,这样就使得这些地方可以保持较高的反应速度。另外,凸起的地方更先于接触到反应气体,故最先进行反应,从而凸起的地方更凸。相反,温度高的地方,沉积速度低而产生凹坑,凹坑的表面不易散热而会使温度变得更高,低凹的地方面气相容易发生涡流,反应气更新速度慢,这样就使得这些地方的反应速度被限制的较慢,从而凹坑的地方更凹。Soret效应使得硅棒表面的高温区的HCl气体浓度很大,而气流在凹坑和凸起的地方最容易形成环流。而凹坑和凸起逐渐发展,相邻近的相互连接在一起,其下面包裹杂质气体,从而生长的硅棒粗糙和疏松。
当温度低于Tmax时,由于具有“自调节效应”,表面可以消除凹凸现象,使得硅的结晶致密,表面光滑而平整。当然,为了维持高的沉积速率,另外避免生成无定型硅,硅棒表面的温度也不能过低。
硅棒表面的形态还受其他因素的影响,例如杂质浓度对晶格的影响以及气体流速和配比对反应速率和表面流动状况。但主要的温度对其形貌的影响具有主要作用。所以还原炉内,尤其是硅棒表面应该保持在适当的速率范围内,不能过于强调反应速率而忽略产品质量,所以温度应该保持在一定的范围(< Tmax)。

图6、硅棒表面的气流分布
炉内硅棒的直径和电阻率的不同也是影响调节效果的重要因素。当直径为20mm,硅棒中心温度约1222℃,表面温度达1102℃;当直径为15mm,硅棒中心温度约1424℃,表面温度达1335℃,这时就容易熔断导致倒棒。所以在硅芯的制作过程中,力求每根硅芯的粗细一样,以便能很好的对电流进行自动控制。
要保持高的沉积反应速率和好的生长质量,温度控制要相当灵敏。利用高温红外测温仪在不同位置测量硅棒的表面温度,再由自动控制系统进行控制调节硅棒的加热电流值。然而,由于红外高温测温仪非常容易发生飘移,造成所测温度偏差很大,故常常造成实际所需电流与根据温度自动调节的电流不符。另外温度控制也可采用电流随时间的预定函数进行顺序控制。
还原炉内温度分布的均匀与否对沉积过程中的质量和能耗有相当大的影响。一般来说还原炉内的温度分布均匀,各处的温度梯度小,沉积速率也相近,生长质量也会很好,电耗也会下降。
一般来讲,反应温度高,硅的结晶性就好,而且表面具有光亮的金属光泽;温度越低,结晶变得细小,表面呈暗灰色。但反应温度也不能过高,因为:
1) 硅与其他半导体材料一样,从气相往固态载体上沉积时有一个最高温度值,反应温度超过这个值时,随着温度的升高沉积速率反而下降。各种不同的硅卤化物有不同的最高温度值,反应温度不应超过这个值。此外,还有一个平衡温度值,高于该温度才有硅沉积出来。一般说来,在反应平衡温度和最高温度之间,沉积速率随温度增高而增大。
2) 温度过高,沉积硅的化学活性增强,受到设备材质沾污的可能性增加,造成多晶硅的质量下降。
3) 直接影响多晶硅品质的磷硼杂质,其化合物随温度增高,还原量也增大,从而进入多晶硅中,使多晶硅的质量下降。
4) 温度过高,还会发生硅的腐蚀反应:
所以过高温度是不适宜的,但是温度过低对反应也不利。还原炉生产中,很大程度上是控制炉内温场,只有当炉内温场稳定,且符合工艺要求时,此时硅的沉积速度将越高,相应还原电耗也会最低。
在实际生产中,前期通过增加还原炉的功率,提升反应温度至1080℃以上,此时的反应主要是还原反应。虽然此时的电流并不是很大,但由于硅棒比较细,电阻非常大,因此其发热量也很大。随着生产的进行,硅棒变粗,电阻降低,反应温度也开始降低,此时三氯氢硅还原反应占主导逐渐转变为三氯氢硅裂解反应占主导。这一点对于还原生产控制而言非常关键,因此在编制进料表时必须要充分考虑此现象。
2、反应配比
在这里要先介绍摩尔的概念,摩尔又称物质的量,1摩尔 (mol) 物质含有6.02×1023个分子,如果是气体,则1摩尔气体在标准状态下 (温度为 0 ℃,压力为1个大气压)的体积为约22.4升。物质的摩尔数(m)与质量的关系为:
如果质量的单位为kg,则算出的摩尔数单位为千摩尔(kmol ) ,如果质量的单位为g ,则算出的摩尔数单位为摩尔(mol)。
还原反应时,氢气与 SiHC13 的摩尔数之比 (也叫配比〕对多晶硅的沉积有很大影响。只有在较强的还原气氛下,才能使还原反应比较充分地进行,获得较高的SiHC13 转化率。如果按反应式计算所需的理论氢气量来还原SiHC13 ,那么不会得到结晶型的多晶硅,只会得到一些非晶态的褐色粉末,而且收率极低。增加氢气的配比,可以显著提高SiHC13的转化率。
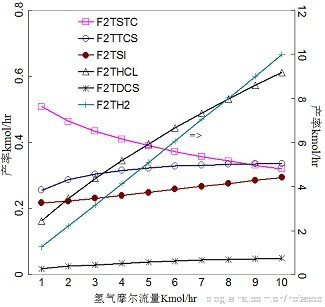
图7、不同H2摩尔流量下的各物料组成
如图7是采用ASPEN plus计算了进料TCS为1Kmol/hr时,H2从1Kmol/hr~10Kmol/hr时系统达平衡时各物料组成。
可见,随着混合进料中H2的增加,抑制了热分解反应,使氢还原反应占主导地位。
通常,实际的转化率远远低于理论值。一方面是因为还原过程中存在各种副反应,另一方面是实际的还原反应不可能达到平衡的程度。但是,总的情况仍然是还原转化率随着氢气与SiHC13 的摩尔比的增大而提高。
但是氢气与SiHC13的配比不能过大,因为:
1) 氢气量太大,稀释了SiHC13 的浓度,减少SiHC13 分子与硅棒表面碰撞的机会,降低硅的沉积速度,也就降低了单位时间内多晶硅的产量。
2)同时,大量的氢气得不到充分的利用,增加了消耗。如果H2量偏高,H2不能得到充分利用,对尾气回收工段而言,其处理负荷也会增大。
3) 从BC13, PCI3的氢还原反应可以看出,过高的氢气浓度不利于抑制B、 P的析出,从而影响产品质量。
由此可知,配比增大,则SiHC13的转化率也增大,但是多晶硅的沉积速率会降低。目前合理的配比是生产前期较高,在4左右,中期在3.0~3.2之间,后期小于3。
对于低配比所带来的SiHC13一次转化率降低的影响,可以通过尾气回收未反应的SiHC13 ,返回多晶硅还原生产中去使用,从而保证SiHC13得到充分利用。
3、炉内压力
原料气体进入炉内停留时间约5~20秒便可以完成化学气相沉积反应。增加压力可使分子的碰撞机率增加,使沉积速率加快。
但是,根据化学平衡的观点,还原炉系统随着压力增加,硅的平衡收率会降低,如图8所示。
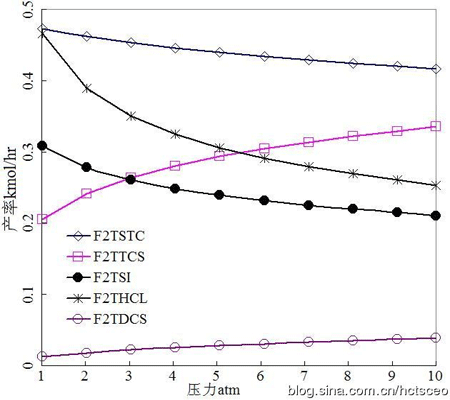
图8 压力对系统平衡的影响
这是因为反应式(1)和(2),
SiHCl3+H2-→Si + 3HCl ……………………………(1)
SiHCl3+3HCl-→SiCl4 + 2H2 ………………………(2)
随着压力升高,(1)平衡会向左进行,才会使得TCS的转化率下降,Si和HCl的收率下降。这就使得虽然系统压力升高,(2)的平衡会向右进行,但是由于系统HCl的生成量降低,导致(2)的反应机率下降,所以STC的收率也会随之下降。
在实际生产中,当压力达到5Bar时,沉积速率便接近了一个相对稳定的状态。
4、气流流速
在保证达到一定沉积速率的条件下,混合气流量越大,炉产量越高。流量大小与还原炉的结构和大小,特别是载体表面积大小有关。因为硅的还原是要沉积在灼热的硅芯上,因此提高流量与增大硅芯和数目相联系着,从分子动力学观点来看,硅芯面积与反应空间之比越大越好,比值越大,气体对沉积面碰撞机会越多,因而对提高实收率是有利的。此外,增加气体流量又与增加气体湍动情况,有效地消除边界层密切相关。
反应混合气体的流速和在反应炉内的循环情况对还原过程有很大意义。通过对还原反应机理和动力学研究认为,反应基本上受扩散控制。由于soret效应,反应生成的HCl气体在灼热硅芯表面造成气体层,如果反应气体在硅芯周围某些部位上循环不足以消除这些气体层,这些部位上就容易沉积出针状或其他突出物,在针状或突出点上特别有利于硅的沉积,进而发展成小结或小瘤。相邻近小结、小瘤联结在一起,其下面夹集气泡,致使沉积硅棒表面粗糙。此外由于气体循环不均,硅芯表面各处温度或浓度不均时,也会出现上述类似的情况。如果加大气体流速和流量,使反应气体在炉内呈正压充分循环对流,则是消除硅棒畸形生长的主要因素。
还原炉内应尽量避免层流,使气流呈湍流状态。一般来说,TCS和H2的混合气体在炉内硅棒表面的流速在1~2m/s左右为宜,这样硅棒表面的气相浓度更新状况会比较令人满意。因而在喷嘴处也要有较高的气速,一般在20m/s左右,形成较强的湍流,使得混合气流在上升过程中,在整个炉内都有较好的浓度分布。
喷嘴形式有两种,一种为直管喷嘴,另一种为发散形喷嘴,如图9所示。
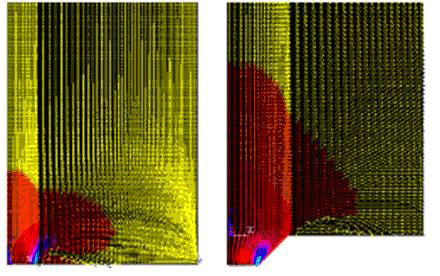
a、直管喷嘴 b、发散形喷嘴
图9、直管喷嘴和发散形喷嘴
这两种喷嘴,对速度的方向分布有影响,但主速度的差别不大。当喷嘴气速大于20m/s时,便可以形成湍流流型,此时喷嘴的形式对湍流而言,已影响不大。喷嘴形式对气流出口方向有较大的影响。喷嘴一般高于还原炉底盘,低于石墨卡瓣尖嘴高度。在喷嘴侧部开孔后对还原炉内空间流体的影响优于无侧孔的喷嘴。还原炉为了保持气体浓度的均匀性,不仅只在底盘中心位置安装一个喷嘴,还在底盘不同半径处增设数个喷嘴以提高进气量和保持气相的均匀性,以促进不同位置的硅棒生长的均一性。12对棒的还原炉就是中底盘中心一个喷嘴,四周均布八个喷嘴。
图10为增设不同位置进气喷嘴后还原炉内流型的变化。

a、仅有中心一个喷嘴

b、增设数个喷嘴
图10、喷嘴对流型的影响
外由于还原炉尾气出口在底部,炉内存在着严重的返混,出口流速也较大,这就势必对从中央喷嘴的侧孔出来的流体有较大的影响,如图11。由于尾气从底盘中央出,导致从侧孔出的流体被直接附带出去。
图12是将侧孔位置上移后的结果,可以看出从侧孔出的气流不再被尾气夹带出去。

图11尾气排气对中心喷嘴侧孔气流的影响

图12 侧孔上移后的流型
所以,在喷嘴上开侧孔有利于气流速度场更好的分布,但侧孔开的位置要靠上。对于安装中央圆心的喷嘴,最好不要开侧孔,以免气体被尾气直接夹带出去,对周围的喷嘴,在较上方位置开侧孔是有利的。
现在通过实际生产的摸索,一种侧孔为螺旋状的喷嘴在许多企业中开始使用。这种喷嘴喷出的物料在炉内成螺旋状上升,有利于增加硅棒顶部的物料浓度,使硅棒横梁位置生产的更好,更结实,可以降低生产后期的倒棒率。
另外,喷嘴的孔径大小也对硅棒生产影响非常大。在等同压力条件下,孔径越大,其喷射的物料高度将会逐渐降低,这样会因为物料的量少而导致硅棒上部,尤其是横梁部位生长缓慢,甚至出现裂棒。另外,孔径过大,会导致硅棒表面粗糙,出现块状颗粒,容易生成爆米花。孔径越小,其喷射的物料高度会增高,但是气流速度会加大,这样就会加大物料对硅棒的冲击,使其发生摇摆或是硅棒出现凹槽,容易出现倒棒,尤其是出现倒芯。
硅棒表面气流速度对硅沉积过程的影响非常大,不仅对多晶硅表面沉积均匀性有影响,而且对硅棒表面粘滞层厚度、对流散热、热扩散、表面Cl/Si/H比例等均有影响,所以维持硅棒表面合理的气体流速是非常重要的。
索比光伏网 https://news.solarbe.com/201207/31/250672.html



